
シリコンウェーハが正しく機能するためには、ほぼ完璧である必要があります。約400~600ステップ、2~3か月かかり、数百万ドルの費用がかかるウェーハ製造プロセス全体を経た後でも、適切な品質管理と検査を行わなければ、ウェーハは半導体デバイスとしての機能を低下させる可能性があります。

製造プロセスと品質に対する高い期待について詳しく知るために、シリコンウェーハの典型的な欠陥を詳しく見てみましょう。今回は、バルクマイクロ欠陥の発見に焦点を当てます。
それらについて知っておくべきことは何ですか?
「バルクマイクロディフェクト」(BMD)は、シリコン中の酸素沈殿物を指すのに一般的に使用される用語です。実際、シリコン格子内の欠陥の多くは欠陥を生じますが、BMDには酸素析出物、ボイド、介在物、スリップラインなど、あらゆる欠陥が考えられます。転位は、結晶成長中だけでなく、エピタキシャル層の成長やインプラント・アニーリングなどのCMOSデバイス製造中のウェーハの熱処理時にも形成されます。
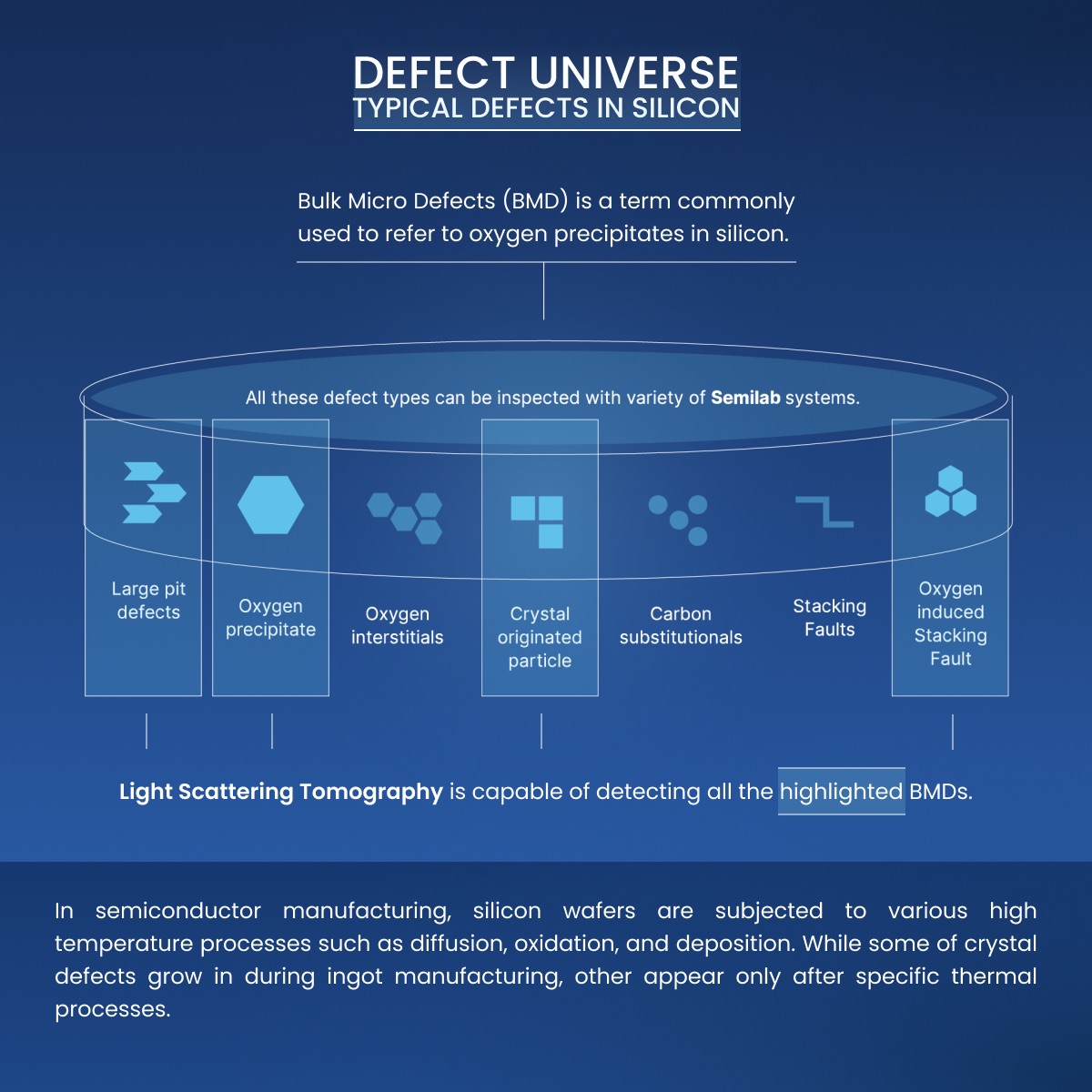
「Defect Universe」グラフを使うと、チップ全体が台無しになり、時間内に検出されなければ貴重な時間とリソースを浪費する可能性のある、小さいながらも重大な欠陥を視覚化できます。
光散乱トモグラフィー法は、数十ナノメートル範囲のバルク単結晶材料の欠陥を検出する強力な方法です。集束された赤外線レーザービームは、半導体ウェーハの割れた表面の近くで、沈殿物、転位、積層欠陥などの散乱物(大量の積層欠陥)を照らします。垂直散乱光は高いNA対物レンズで集光され、その画像は近赤外感度CCDカメラで検出されます。

LST-2500HDシステムは、3つのHD機能を備えており、光散乱断層撮影法を利用してバルク欠陥を検出する方法です。高ダイナミックレンジ、高検出速度、高検出可能性の機能を組み合わせたこの装置は、12 nmという小さなBMDの検出において現在入手可能な最も感度の高いツールとなっています。

当社の低角度光散乱断層撮影ソリューションにより、メーカーは欠陥のある材料を選別できるため、貴重な時間とリソースを節約できると同時に、完璧なチップのみを市場に出し、無駄な製品を生産しないようにすることができます。