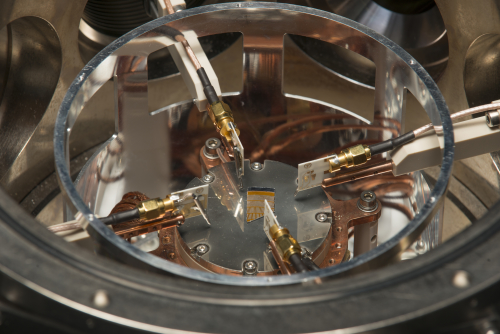
ディープレベル過渡分光法(DLTS)は、ウェーハ検査の分野で有望なツールです。これは半導体の電気活性欠陥を研究する実験的な方法です。研究者はDLTSを利用して、「フィンガープリント」に不可欠な基本的な欠陥パラメータを確立できます。感度が高いため、この分野では優れています。実際、深準位過渡分光法は、ほとんどの半導体診断技術の感度を超えています。DLTS は、10 分の 1 の濃度のシリコン中の不純物を検出できます。12 材料のホスト原子のこれは欠陥の特定と分析に非常に役立ちます。また、半導体のバンドギャップ内の電子状態に関する包括的な洞察も得られます。
この記事では、ウェーハ検査におけるDLTSの重要性、その応用分野、およびDLTSがもたらす独自の機能について詳しく説明します。
DLTSの中核は、静電容量と電流トランジェントを測定することです。このシステムは、DLTS システムに不可欠なロックイン積分器とクライオスタットを採用しています。興味深いことに、容量トランジェントはサンプル自体によって生成され、その後機器で測定されます。ロックイン技法の採用時に温度スイープが適用されるため、機器は余分なノイズをすべて除去し、トランジェントを正確に評価できます。
この方法の主な利点は、過渡データを取得できることです。このデータは、ウェーハの特性評価に不可欠な汚染や欠陥に関する貴重な情報を提供します。不純物検出で得られる感度は他に類を見ないもので、2 x 10 未満でも検出できます。8 原子/cm3。これは主に、メイン測定ユニットの優れた信号対雑音比によるものです。
DLTSは、ウェーハおよびEPIメーカー、ICファブ、研究機関など、多くのユーザーに適用できます。 注目すべきユースケースは、Si中の鉄汚染の検出です。 Fe-Bペアは熱処理によって解離する可能性があり、Fe間質ピークが増加します。興味深いことに、このプロセスは可逆的です。サンプルをリラックスさせると、ピークが小さくなります。
最適な結果を得るには、サンプルの特性が重要です。理想的なサンプルの特性は測定の目的によって大きく異なりますが、一般的に適用できる条件がいくつかあります。
DLTS には多くの利点がありますが、その制限を認識することが不可欠です。この方法は本質的に破壊的であり、サンプル調製が必要です。サンプルサイズはクライオスタットによって異なり、用途の正確な性質がクライオスタットの温度範囲に影響します。
深層過渡分光法は、ウェーハ検査に欠かせないツールとしての地位を確固たるものにしています。比類のない感度で汚染分析を行うことができるため、半導体業界の専門家に好まれる選択肢となっています。Semilabでは、お客様のニーズに合わせた最先端のDLTSソリューションを提供することに誇りを持っています。お客様のウェーハ特性評価ニーズに応えるセミラボのDLTSの可能性を最大限に引き出すには、 専用の DLTS ページをご覧ください。一緒に、半導体の研究開発の限界を押し広げましょう。