
Semilab En-Vision システムの独自の機能、用途、利点をご覧ください。
En-Visionは非接触かつ非破壊的な測定システムで、特にシリコン表面の下にある、従来の検査ツールでは見えず、デバイスの性能や歩留まりに影響を与えるnmスケールの埋もれた欠陥を迅速かつ正確に検出することを目的としています。En-Vision システムの大きな利点の 1 つは、高度な欠陥検出を可能にする強化されたビジョンです。En-Vision は比類のない測定画像品質を提供し、欠陥検出をより簡単かつ正確に行えるようにします。これにより、さまざまな用途で欠陥検出が次のレベルに引き上げられます。

En-Visionシステムは、注入プロセスの監視、シリコンのエピタキシャル層成長の欠陥の検出、トレンチ付近の結晶学的欠陥の特定に役立ちます。
シリコンサンプルの注入プロセス中に、結晶構造が破損し、アニーリング処理が回復した後でも、影響を受けた体積に範囲終了時の欠陥が残る可能性があります。En-Visionを使用すれば、注入プロセスを監視して欠陥を検出し、その分類に関する詳細な情報を提供できます。En-Vision システムでは、バルク微小欠陥 (BMD) の密度、放射状および垂直方向の分布に関する詳細な情報を使用して検出できます。

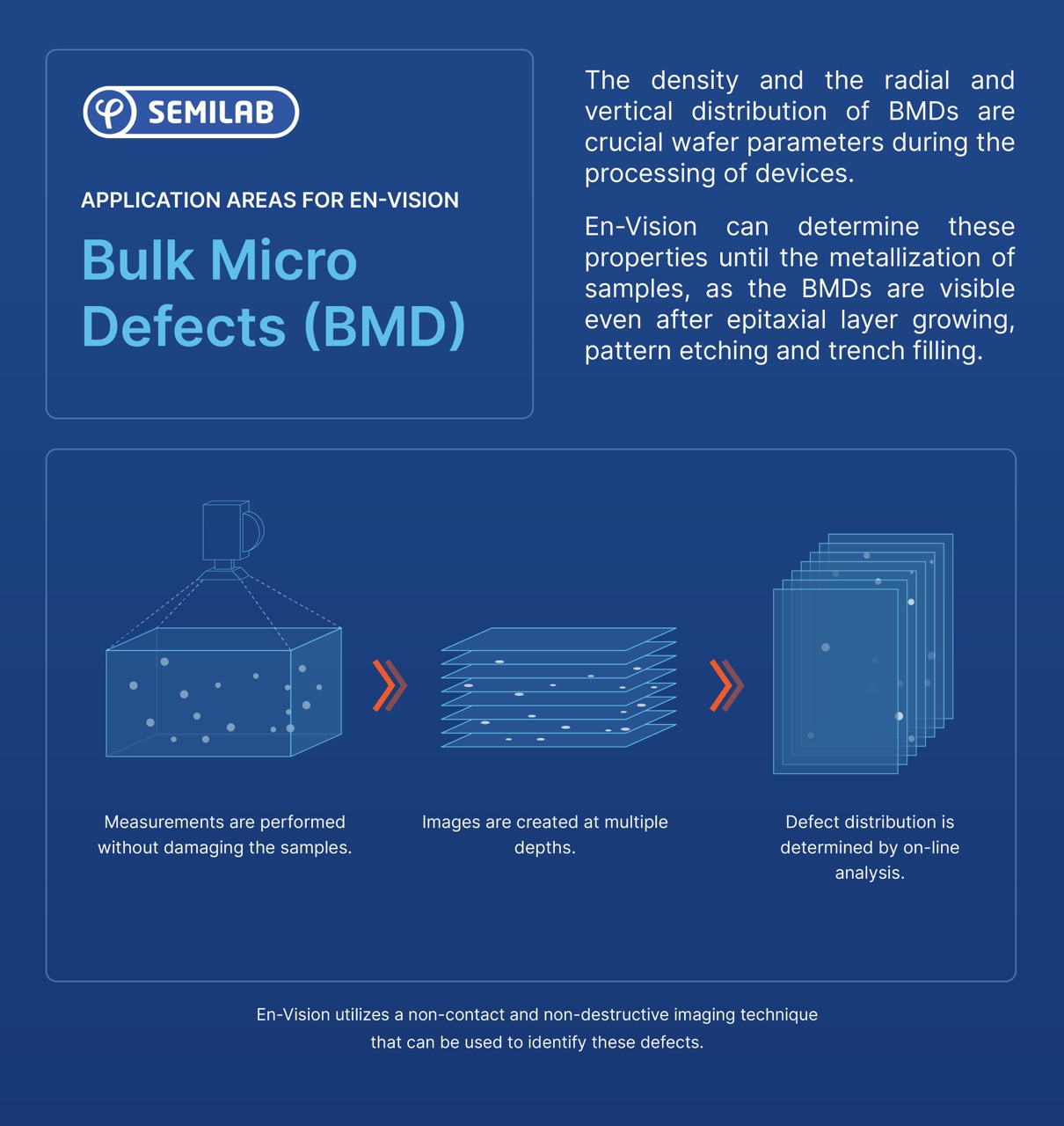
En-VisionはEPI欠陥モニタリングにも優れたソリューションです。これは、シリコンのエピタキシャル層成長における欠陥を検出する従来の方法では、時間がかかり、破壊的であることが多いためです。しかし、En-Visionは、これらの欠陥を迅速かつ費用対効果の高い方法で特定できる、効率的な非接触かつ非破壊的な方法を提供しています。
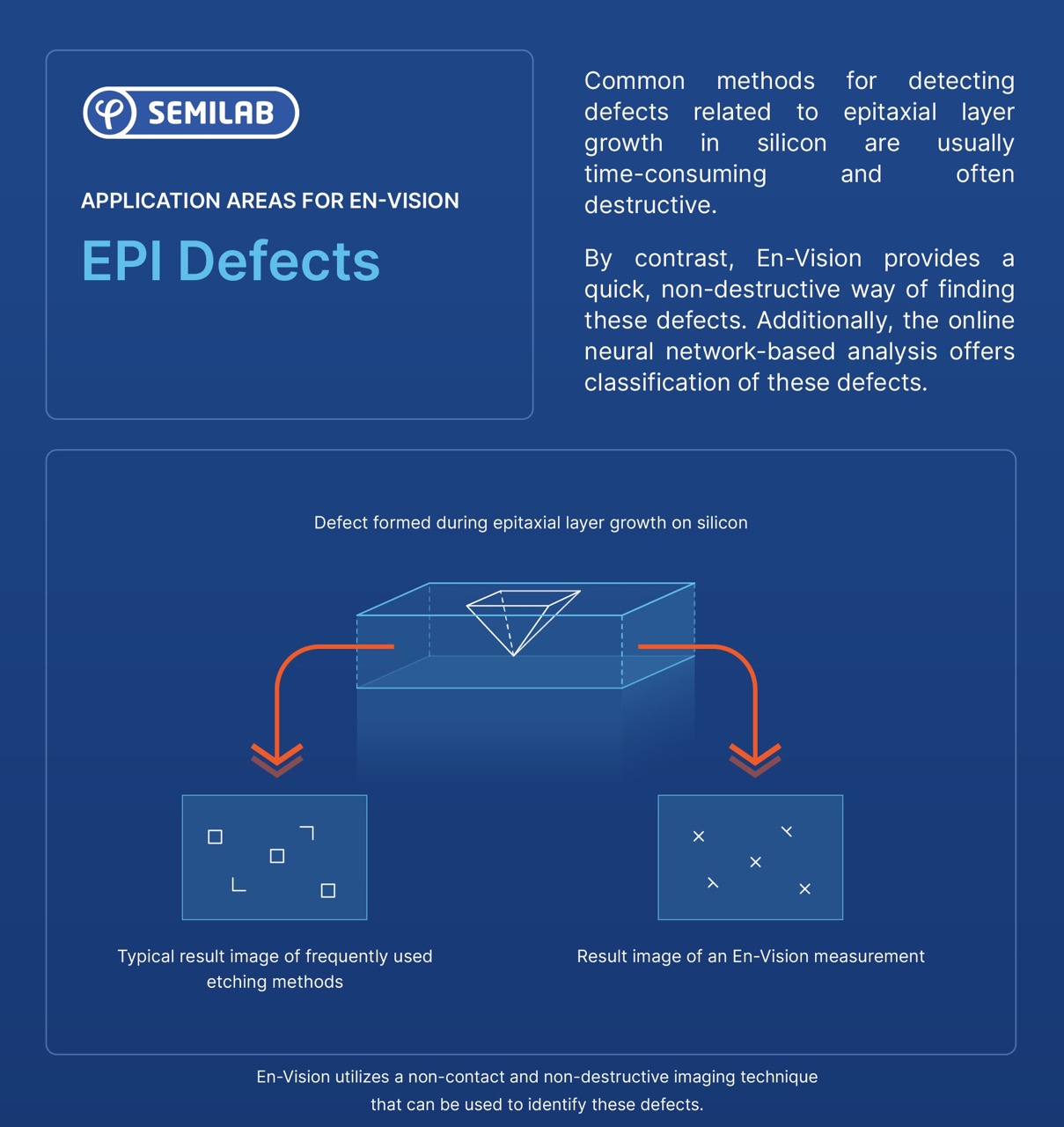
また、En-Visionは、さまざまな深さで材料を監視することにより、DTIによって誘発される欠陥密度の重症度に関する情報も提供します。これにより、深溝分離における欠陥の検出と材料構造の特性評価が可能になります。

En-Visionは独自の機能により、インプラント欠陥、バルクマイクロディフェクト(BMD)、エピ欠陥、ディープトレンチアイソレーションの検出など、幅広い用途でより正確で効率的な欠陥検出を可能にします。これにより、En-Vision計測システムは半導体業界のゲームチェンジャーとなっています。
Semilab En-Visionシステムとその結果について詳しく知りたい場合は、次の出版物でさらに詳しく調べることができます。
深溝を有する0.18μmパワー半導体デバイスにおける転位生成のマイクロフォトルミネッセンスイメージング
IC処理中の欠陥フォトルミネッセンスイメージング(DPLI)の用途のレビュー